
CMP (chemical mechanical polish) 化學機械研磨是半導體製程中非常重要的一步
之前的文章提到了CMP化學機械研磨的基礎知識,可看 輕鬆了解半導體製程中晶圓平坦化
而 CMP 後的 wafer 研磨表現就非常的重要,這會影響到後續的製程
因此,這篇主要介紹 "判斷 CMP 研磨表現的5大關鍵指標",這些都是 CMP 過程中會監控的項目
RR (Removal Rate) - 研磨速率指標
晶圓製造過程有幾百道製程,因此可以說每一道製程是以秒計算的,節省了幾秒鐘可能就提升了好幾%的產能
而CMP就是將wafer上多餘的材料磨掉,使晶圓平坦化
研磨參數、slurry 成份、研磨墊 (CMP pad) 、鑽石碟(Disk) 設計等皆會影響 RR
可想而知,當研磨速率越快時,每一片晶圓所需的研磨時間就越短,如此產能就可以提升
乍聽之下好像RR越高就越好,然而,RR太高也可能會影響研磨表現與 研磨終點 (EPD) 的控制
因此通常RR會控制在一個適當的範圍,兼顧產能的要求與研磨的表現
Step Height & Dishing - 平坦化指標
通常在metal或Oxide沉積時會產生高低差,但研磨之後也會存在高低差,我們稱為 Step Height 或 Dishing
不過由於化學機械研磨主要目的是將晶圓表面磨平,因此 Step Height 或 Dishing 越小越好
然而,研磨速率RR越快,就越容易Over polish 產生 Step Height 或 Dishing,所以才說RR並非越高越好~
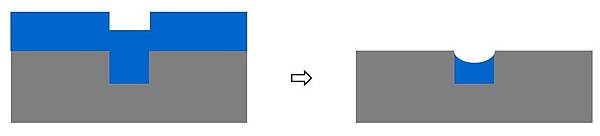
Erosion - 平坦化指標
有時候研磨參數沒有調整好或 slurry、disk、CMP pad 的搭配不佳,就可能導致嚴重的過度磨耗,稱為 Erosion
不僅是沉積的物質過度磨耗,連同旁邊的絕緣層也過度磨耗,如下圖所示

Defect 缺陷
一般常見的 CMP 後缺陷主要分為2種,Particle 或 Scratch
Particle 是髒污的殘留,不論是小顆粒或大面積的髒汙,主要來自於 CMP 中的物質殘留於 wafer 上
而 Scratch 就是某些物質在 wafer 上產生了刮痕,像是 CMP disk 鑽石碟就有可能因為掉鑽而導致 wafer 的刮傷
NU% (Nonuniformity) - 研磨均勻性
一整片 wafer 在研磨完時,wafer 的中心到邊緣是否研磨的均勻很重要
如果 wafer 的中心磨耗量正常,但 wafer 的邊緣磨耗量超大,這樣可能倒至 wafer 邊緣的晶片無法使用而報廢,這會減少良率與產能~
所以NU%越小越好,當然有一些特殊情況不討論
但現在的CMP研磨頭設計,上面的 membrane (晶圓吸附墊) 都有好幾個區段的設計,可以調整wafer不同區域的受力大小,因此可藉此改善NU%
參考資料: Chemical mechanical planarization for microelectronics applications






 留言列表
留言列表